GaN 신뢰성 및 수명 예측: 15단계(7)
DC-DC 컨버터(I)
글/Ricardo Garcia, Siddhesh Gajare, Ph.D., Angel Espinoza, Max Zafrani, Alejandro Pozo, Ph.D., Shengke Zhang, Ph.D., EPC
우주선(cosmic ray)
태양광 패널은 실외에 설치되므로, 태양광 인버터 애플리케이션에 사용되는 디바이스들은 우주 공간으로부터 우주선에 의해서 에너지를 띤 입자들의 타격을 받을 수 있다. Si MOSFET과 SiC 디바이스 같은 전력 디바이스로 지상의 중성자가 심각한 결함을 초래할 수 있는 치명적인 입자인 것으로 밝혀지고 있다[38-40]. 연구 결과들을 보면, MOSFET과 SiC 디바이스로 발생되는 결함 비율은 대체적으로 시간에 걸쳐서는 일정하나 전압과 고도에 따라서는 강하게 종속적이고 온도에 따라서는 약하게 종속적인 것으로 나타난다.
그림 33은 평방센티미터에 4 x 1015에 이르는 선량으로 중성자 방사선 충격에 대해서 100V 정격 GaN 디바이스의 테스트 결과를 보여주는 것으로서, 평균적인 파라미터 값의 변화가 최소한이라는 것을 알 수 있다. 4 x 1015 n-cm2의 선속(fluence)을 견딜 수 있다는 것은 SiC 기반 및 Si 기반 전력 디바이스로 알려진 것보다 훨씬 높은 것이다.
중성자 충격에 대해서 디바이스들의 주된 결함 메커니즘은 변위 손상(displacement damage)이다. 고 에너지 중성자가 결정 격자로 원자들을 산란시키고 격자 결함을 일으키기 때문이다. 그림 33의 결과는, 중성자가 GaN 결정과 전체적인 디바이스 구조에 미치는 영향이 미미하다는 것을 보여준다.
GaN이 중성자 방사선을 더 잘 견딜 수 있는 이유는, GaN이 실리콘에 비해서 변위 임계 에너지가 훨씬 더 높기 때문이다. 어떤 결정의 변위 에너지는 결정 원소들의 결합 강도에 비례한다. 그림 34에서 보듯이, 갈륨과 질소의 결합 에너지는 실리콘 전력 MOSFET으로 실리콘 원자들의 결합 에너지보다 훨씬 높다.

[그림 33] 4 x 1015cm2에 이르는 선량으로 중성자 방사선이 100V 정격 eGaN 디바이스에 미치는 영향(FBG10N30은 EPC2001C의 내방사선 버전 사용)
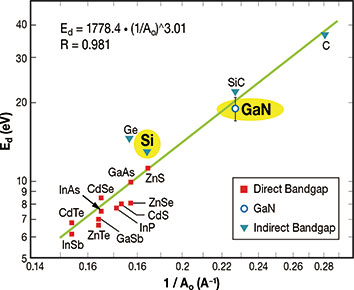
[그림 34] 다양한 물질들의 격자 상수 역에 따른 변위 임계 에너지 그래프
DC-DC 컨버터
이 장에서는 대표적인 DC-DC 컨버터 활용 사례로서 (i) 동기 정류기와 (ii) 벅 컨버터(상측 및 하측 FET)로 5장에서 설명했던 동적 RDS(on) 모델을 적용 한 것을 설명한다. 이 계산을 위해서 2단계 시뮬레이션 프로세스를 사용했다.
첫 번째 단계에서는, 애플리케이션 회로의 실제적인 SPICE 모델을 개발했다. 여기에는 실제 레이아웃으로 발생되는 주요 기생 인덕턴스의 영향을 포함했다. 이들 기생성분은 일차적으로 링잉과 전압 오버슈트에 영향을 미치고, 그러므로 결국에 FET의 동적 RDS(on)에 영향을 미친다. 기생 인덕턴스를 정격 값에서 (PCB 레이아웃을 불량하게 했을 때에 해당되는) 극단적인 값으로 변화시켜서 시뮬레이션을 실시했다. SPICE 시뮬레이션으로 단일 스위칭 사이클로 시간을 세분해서 FET 내부에서의 채널 전류와 드레인-소스 전압을 포착했다.
두 번째 단계에서는, 이러한 단일 사이클 전류-전압 파형을 (MATLAB으로 구현된) 열 전자 포획(hot electron trapping) 모델로 불러오기 했다. 이 모델을 사용해서 첫 번째 스위칭 사이클로 발생되는 전하 포획을 계산하고 어느 시점에 가장 많은 충전(charging)이 발생되는지 알아보았다(다시 말해서 턴온 전이 시인지 아니면 턴오프 전이 시인지). 더불어, 10년 이상의 지속적인 작동에 걸쳐서 발생되는 누적 전하 포획을 알아보기 위해서 동일한 스위칭 사이클을 수조 개에 걸쳐서 적분했다.
순간 포획 비율은 누적 포획 전하에 따라서 종속적이므로(비선형적), 사이클당 충전 양은 일정하지 않으나, FET이 스위칭하는 것에 따라서 시간이 경과하면서 빠르게 스스로 소멸한다. 시간이 경과하면서 충전이 포화될 뿐만 아니라, 디바이스가 작동함에 따라서 스위칭 파형 내에서 위험한 구간이 변화할 수 있다. 벅 컨버터의 하드 스위칭 상측 FET을 예로 들 수 있다. (이 사례에 관해서는 뒤에서 자세히 설명한다). 처음에는 주로 턴온 전이 시에 높은 전류/중간 전압으로 전하 포획이 발생한다. 하지만 장시간 작동한 후에는 이 프로세스가 완전히 소멸하고 이후의 모든 충전은 턴오프 전이 시에 낮은 전류/높은 전압으로만 발생된다.
이 계산에 의하면 다음과 같은 결론을 도출할 수 있다:
48V-12V LLC 동기 정류기:
• 이러한 제로 전압 스위칭(ZVS) 조건 하에서 동적 RDS(on)(dRDS(on))이 대체로 매우 양호하다.
• 12V 출력과 24V 버스 전압으로, 기존의 40V 트랜지스터 대신에 30V 트랜지스터를 사용하는 것을 고려할 수 있다.
최신 세대 100V GaN 디바이스를 채택한 벅 컨버터로 하측 FET(소프트 스위칭):
• 턴온 전이 시에 80V 버스 전압 위로 50V 오버슈트라 하더라도 dRDS(on)이 양호하다.
• 170V에 이르는 극단적인 오버슈트이면 dRDS(on)이 좀더 눈에 띄게 증가할 수 있다.
최신 세대 100V GaN 디바이스를 채택한 벅 컨버터의 상측 FET(하드 스위칭):
• 40V의 온건한 오버슈트(130V 피크)일 때는 주로 턴온 전이 시에 전하 포획이 일어나고, 장기적 dRDS(on)은 양호하다.
• 90V의 극단적인 오버슈트(170V 피크)일 때는 고전압 링잉에 이어서 턴오프 전이 시에 주로 전하 포획이 일어나고, 장기적 dRDS(on)이 염려스러울 수 있다.
(1) 전류 종속적 열 전자 포획 모델
개별 스위칭 사이클로 동적 전하 포획을 시뮬레이트하기 위해서 앞서 논의했던 기본적인 미분 방정식으로 두 가지 간단한 일반화를 적용했다. 첫째, 순간 포획 비율이 채널 전류(I)에 선형적으로 비례한 것으로 가정했다. 디바이스의 물리학적 관점에서 이러한 가정은, 채널 전자들이 (상호작용을 하지 않고) 독립적으로 작용하고 각각의 전자가 충분한 운동 에너지로 표면 장벽을 넘어가서 포획될 확률이 동일하다고 하는 것과 같다. 두 번째 일반화는 시간에 걸쳐서 적분과 관련된 것이다. 앞서의 분석에서는, 전류와 전압이 시간에 걸쳐서 변하지 않는 것으로 가정했다.
그럼으로써 시간에 따른 표면 전하에 대한 닫힌 형식의 해석적 해를 얻을 수 있었다. 이 글에서 살펴보는 좀더 일반적인 사례들로는 스위칭 사이클로 전류와 전압이 시간적으로 변하는 것으로 했다. 그러므로 닫힌 형식의 해를 얻을 수 없으며, 시간에 걸쳐서 명시적으로 적분을 해야 한다. 그러므로 아래에서 보는 공식 8의 일반 해로 이어진다. 스위칭 파형의 복잡성 때문에 이 적분은 수치적으로 실시해야 한다.
![]() (8)
(8)
공식 8은 GaN 트랜지스터로 동적 RDS(on)에 관한 이론적 이해에 있어서 획기적인 진전을 나타낸다. 연구자들은 오래 전부터, 이러한 디바이스로 전류와 전압이 열 전자 포획의 주된 동력이라고 알아 왔다. 하지만 이 둘의 영향을 어떻게 수학적으로 결합해서 누적 포획 전하와 동적 RDS(on)을 계산할지는 알지 못했다.
공식 8에서 보듯이, 전류의 영향은 선형적이나, VDS(전계 항 F에 해당)의 영향은 극히 비선형적이고 누적 포획 전하 QS에 따라서 종속적이다. 이러한 이유에서, FET이 더 긴 시간에 걸쳐서 스위칭하고 QS가 상승함에 따라서, 극히 높은 전계 F와 극히 높은 VDS로 가장 활동적인 전자만이 추가적으로 포획된다. 뒤에서 실제 활용 사례들을 살펴보면 이 영향을 좀더 분명하게 확인할 수 있다.
그러면 실제 사례들을 살펴보도록 하겠다. 첫 번째 사례는 1MHz로 동작하는 48V-12V LLC 동기 정류기로서, 이차측 트랜지스터의 RDS(on)이 어떻게 나빠지는지 알아본다.
(2) 48V-12V LLC 동기 정류기
이 회로의 SPICE 모델은 EPC9149 데모 보드를 기반으로 한다. 그림 35는 회로와 모델 파라미터를 보여준다. 각기 다른 오버슈트로 각기 다른 파형을 생성하기 위해서 트랜스포머 단자 각각의 출력으로 누설 인덕턴스 L1, L2, L3, L4를 다 합쳐서 50pH에서 150pH로 변화시켰다. 그림 36에서 보듯이, 이 인덕턴스 값을 높이면 더 높은 링잉과 오버슈트를 발생시킨다는 것을 알 수 있다.
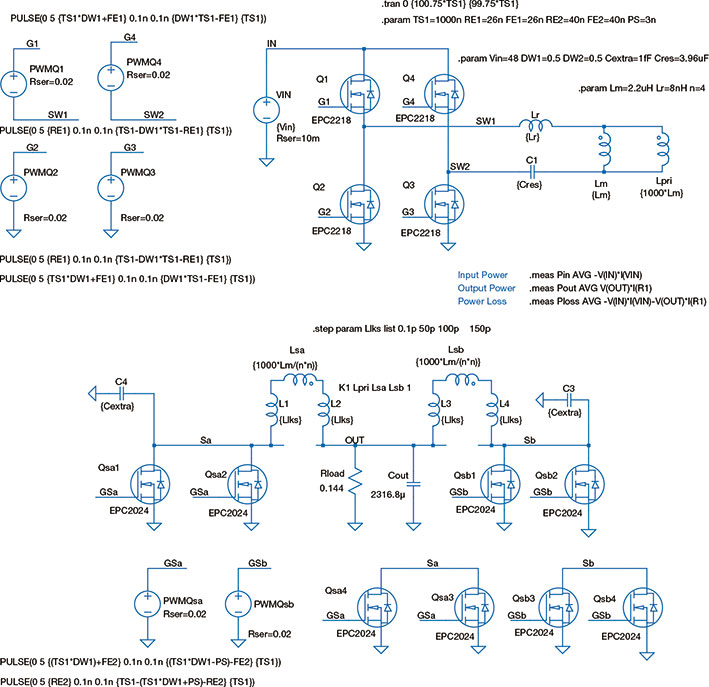
오버슈트를 달리 하고 40V(사례 1과 2) 또는 30V (사례 3과 4) 정격 GaN 디바이스를 사용해서 4가지 사례를 분석했다. 이들 모든 사례들로 eGaN FET이 ZVS 턴온 및 하드 스위칭 턴오프를 한다. 첫 번째 사이클부터 1천만 번째 사이클까지 전체적인 스위칭 파형 시퀀스에 걸쳐서 전압, 전류, dRDS(on)을 계산했다. 그림 36은 1천만 번째 사이클에 전류와 전압 파형을 보여준다. 매 사이클로 포획된 전하 양 QS를 계산하고 이전 사이클과 더했다.
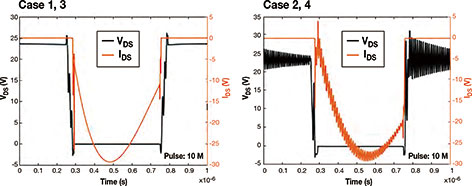
① 40V GaN 트랜지스터를 사용한 사례 1과 사례 2
그림 37은 10년에서 끝나는 log(t) 스케일로 40V 디바이스를 사용했을 때의 계산 결과를 보여준다. 두 사례 모두로 포획 전하가 누적되는 것을 거의 볼 수 없으며, 그러므로 RDS(on)이 증가하는 것을 볼 수 없다. 또 다른 두 사례는 RDS(on)이 더 낮은 30V GaN FET을 사용한 것이다. 전압이 더 낮은 디바이스가 40V 디바이스보다 대체로 좀더 효율적이다.

② 30V GaN 트랜지스터를 사용한 사례 3과 사례 4
그림 38은 위 사례들과 동일한 회로로 30V EPC-2023 GaN 트랜지스터를 사용한 계산 결과를 보여준다. 가장 극단적인 사례로도 RDS(on)이 약 5% 정도밖에 증가하지 않는다는 것을 알 수 있다. 그러므로 30V 디바이스를 이 회로로 극히 높은 오버슈트로도 안전하게 사용할 수 있다고 할 수 있다.


5세대에 이르기까지의 개발 여정
조회수 82회 / Alex Lidow

EPC의 5세대 eGaN® 기술 “새로운 차원의 성능으로 비약적 도약”
조회수 98회 / Alex Lidow
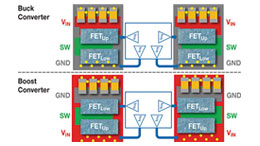
GaN FET에 실리콘 MOSFET 게이트 드라이버를 사용하기 위한 방법
조회수 244회 / Alejandro Pozo

최고의 GaN 게이트 드라이버 선택
조회수 245회 / 류창우
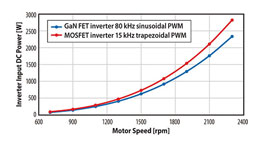
GaN 모터 구동 인버터를 활용한 농업용 드론 혁신
조회수 280회 / EPC
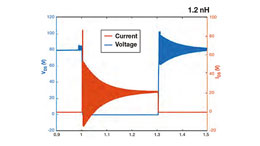
GaN 신뢰성 및 수명 예측: 15단계(8)
DC-DC 컨버터(Ⅱ)
조회수 299회 / Ricardo Garcia 외 5인
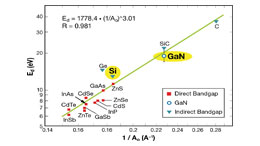
GaN 신뢰성 및 수명 예측: 15단계(7)
DC-DC 컨버터(I)
조회수 343회 / Ricardo Garcia 외 5인

GaN 신뢰성 및 수명 예측: 15단계(6)
“test-to-fail” 방법론을 사용...
조회수 513회 / Ricardo Garcia 외 5인
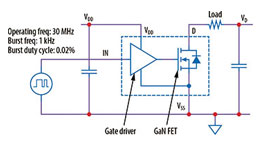
GaN 신뢰성 및 수명 예측: 15단계(5)
조회수 573회 / Ricardo Garcia 외 5인
PDF 다운로드
회원 정보 수정