고전압 스위치 모드에 GaN 전계 효과 트랜지스터를 적용하는 이유와 방법
글/Art Pini, Digi-Key 북미 편집자 제공
전력 효율성은 사회적 요구사항과 규제 사항을 직면하는 요즘, 전자 시스템의 우선순위이다. 특히 전기 자동차(EV)부터 고전압 통신 및 산업 인프라에 이르는 응용 분야의 경우, 전력 변환 효율과 출력 밀도는 설계 성공 여부에 중요한 영향을 미친다.
이러한 요구사항들을 충족시키기 위해, 스위치 모드 전력 시스템의 설계자는 고전적인 실리콘(Si) 기반의 금속 산화물 전계 효과 트랜지스터(MOSFET)와 절연 게이트 양극성 트랜지스터(IGBT)의 사용으로부터 전환할 필요가 있다. 기존의 트랜지스터들은 이론적인 한계에 빠른 속도로 도달하고 있기 때문이다.
설계자는 실리콘(Si) 기반의 금속 산화물 대신에 질화갈륨(GaN)과 같은 와이드 밴드갭(WBG) 물질을 기반으로 한 장치를 고려해야 한다. GaN 장치는 Si 장치보다 더 빠르게 전환하고, 더 높은 전압 및 전력 수준을 처리하며, 주어진 전력 수준에 비해 훨씬 더 작고, 훨씬 더 높은 효율로 작동한다.
이 기사에서는 GaN FET의 기본 사항을 살펴보고, 스위치 모드 전력 회로에서 기존 Si 장치에 비해 장점을 보여주며, Nexperia의 실제 사례를 소개하여 그 응용 분야에 대해 이야기한다.
GaN FET의 기본 사항
고전압 반도체 스위치는 전력 변환 회로의 근본 요소이다. 설계자는 온 상태 직렬 저항을 줄여 전도 손실을 줄이고, 전환 속도를 높여 스위칭 손실을 줄이며, 기생 효과를 줄이는 방법으로 이러한 장치의 성능을 향상하는 데 중점을 두어 왔다. 이 설계 노력은 일반적으로 실리콘 MOSFET 및 IGBT에 대해 성공적이었지만, 이러한 장치의 작동이 이론적인 한계에 도달함에 따라 개선 속도가 느려지고 있다.
그 결과, 지난 몇 년간 실리콘 카바이드(SiC)와 GaN을 사용한 WBG 장치가 대량 생산에 도달할 정도로 도입되었다. 이러한 장치는 더 높은 작동 전압 범위, 더 빠른 스위칭 시간 및 더 높은 효율성을 제공한다.
반도체의 밴드갭이란 전자를 자극해 결합 상태로부터 자유 상태로 유도해서 전기를 흐르게 하는 데 필요한 최소 에너지를 의미한다(표 1).
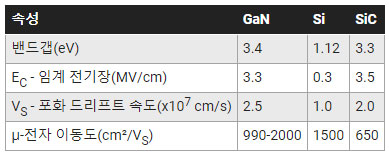
밴드갭이 1.12eV인 Si에 비교하면, GaN과 SiC는 각 3.4eV와 3.3eV로 밴드갭이 3배가량 높은 화합물 반도체이다. 이는 GaN과 SiC 모두 더 높은 전압과 더 높은 주파수를 지원할 수 있음을 의미한다.
GaN의 더 높은 전자 이동성은 고성능, 고주파 응용 분야에 훨씬 더 적합하다. GaN 전력 FET에 의해 가능해진 더 빠른 스위칭 속도와 더 높은 작동 주파수로 인하여 개선된 신호 제어, 더 높은 차단 주파수를 갖는 수동 필터 설계 및 더 낮은 리플 전류가 가능하게 된다. 이를 통해 더 작은 인덕터, 커패시터 및 변압기를 사용할 수 있어 전체적인 크기와 무게를 줄일 수 있다.
GaN FET는 고전자 이동 트랜지스터(HEMT)라고 불린다. FET 구조의 기능은 높은 전자 이동성이다(그림 1).
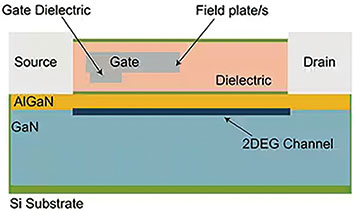
게이트 아래에는 공핍 영역이 형성된다. 게이트의 작동은 인핸스먼트 모드 전력 실리콘 MOSFET인 N 채널과 유사한다. 이 장치의 게이트에 인가된 양(플러스)의 전압으로 게이트를 켠다.
이러한 구조는 전력 장치를 형성하기 위해 여러 차례 반복된다. 결과적으로 전원 스위칭을 위한 기본적으로 간단하고 세련되며 비용 효율적인 솔루션을 얻을 수 있다.
더 높은 전압 장치를 만드는 경우, 드레인과 게이트 사이의 거리가 증가하게 된다. GaN 2DEG의 고유 저항은 매우 낮으므로, 차단 전압 용량의 증가에 따른 저항에서의 영향은 실리콘 장치에 비해 훨씬 적다.
GaN FET는 인핸스먼트 모드 또는 공핍 모드의 두 가지 구성 중 하나로 작동하도록 구성될 수 있다. 인핸스먼트 모드 FET는 평상시에는 꺼져 있으므로 FET를 켜려면 드레인/소스에 상대적인 양의 전압을 게이트에 적용해야 한다. 공핍 모드 FET는 평상시에는 켜져 있으므로 FET를 끄려면 드레인/소스에 상대적인 음의 전압을 게이트에 적용해야 한다. 공핍 모드 FET는 전력 시스템에서 문제가 된다. 그 이유는 시스템 전원을 켜기 위하여 GaN 공핍 모드 FET에 네거티브 바이어스가 적용되어야 하기 때문이다.
이 문제를 해결하는 한 가지 방법은 캐스코드 회로 구성에서 저전압 실리콘 FET를 공핍 모드 GaN FET와 결합하는 것이다(그림 2).
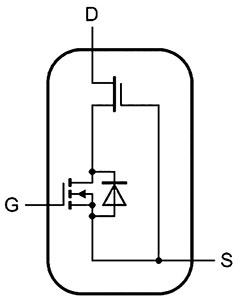
캐스코드 회로는 Si MOSFET 게이트 구조를 사용하여 기존의 MOSFET 게이트 드라이버 IC와 일치하는 더 높은 게이트 구동 제한점과 전원을 켤 때 공핍 모드 GaN FET가 오프되는 장점을 갖고 있다.
GaN FET의 주요 특징 중 하나는 높은 효율성이다. 이는 낮은 직렬 저항으로 인해 전도 손실이 감소하고, 더 빠른 스위칭 시간으로 스위칭 손실을 낮추며, 낮은 역 복구 손실을 설명하는 낮은 역 복구 비용 때문이다.
일반적인 하프 브리지 부스트 컨버터 토폴로지를 사용하여 GaN FET와 Si MOSFET의 효율을 비교할 수 있다(그림 3).
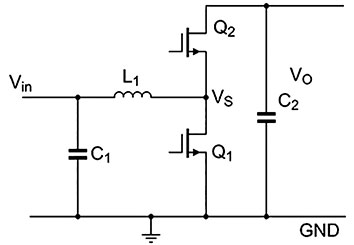
부스트 컨버터의 입력 전압은 240V, 출력 접압은 400V, 스위칭 주파수는 100kHz이다. 최대 3500W의 출력 범위에서 효율과 손실을 비교한다(그림 4).

GaN FET는 MOSFET에 비해 효율이 약 20% 더 높고 전력 손실은 약 3배수 정도 더 낮다. 2000W일 때, MOSFET에서의 손실은 약 62W이지만 GaN FET에서의 손실은 19W에 불과하다. 즉, 냉각 시스템이 더 작아질 수 있으므로 부스트 컨버터의 체적 효율이 향상될 수 있음을 의미한다.
GaN FET의 최대 전압 제한이 더 높으므로, 측정이 거의 3500와트까지 수행되었다는 것은 덜 알려진 사실이다. 이처럼 GaN FET는 확실한 장점을 가지고 있다.
더 높은 전압을 위해 GaN 시작하기
Nexperia는 고전압 응용 분야를 위해 두 개의 650V GaN FET인 GAN063-650WSAQ 및 GAN041-650WSBQ를 제공한다. 두 개 모두는 통상시에 꺼져 있는 N 채널 FET이다. GAN063-650WSAQ는 650V의 최대 드레인-소스 전압을 처리하도록 정격되었으며 800V의 과도 전류(마이크로초 미만의 펄스 폭으로)를 유지할 수 있다. 이 장치의 정격은 34.5A의 드레인 전류와 25℃에서 143W의 소비 전력이다. 드레인-소스 온 상태 저항은 통상적으로 50mΩ이며 최대 제한은 60mΩ이다.
GAN041-650WSBQ는 800V 과도 한계와 동일한 650V 최대 드레인-소스 전압 정격을 갖다. 이는 상온에서 47.2A의 최대 드레인 전류와 187W의 소비 전력을 처리할 수 있다는 점이 다르다. 통상적인 채널 저항은 35mΩ이며 최대 41mΩ이다.
하프 브리지 구성에서 GAN063-650WSAQ를 사용하는 Nexperia 참조 설계가 그림 5에 나와 있다.

이 회로도는 GaN FET의 게이트를 구동하는 데 사용되는 Si8230 고/저 이중 절연 게이트 드라이버를 보여준다. 게이트 드라이버의 출력은 모든 GaN 장치에 필요한 30Ω 게이트 저항기를 통해 게이트에 연결된다. 게이트 저항기는 동적 스위칭 성능에 영향을 미치며 게이트 정전 용량의 충전 시간을 제어한다. FET의 드레인과 소스 사이의 R-C 네트워크 또한 스위칭 성능을 제어하는 데 도움이 된다. GaN FET의 게이트 구동 레벨은 0V ~ 10V 또는 0V ~ 12V이다.
GaN FET의 높은 스위칭 속도(일반적으로 10ns ~ 11ns 범위) 기생 유도 용량을 최소화하기 위해 신중한 레이아웃과 전압 및 전류 과도현상으로 인한 링잉을 완화하기 위해 RC 스너버 사용을 요구한다. 고전압 공급 장치와 접지 간의 설계에는 여러 개의 RC 스너버(R17 ~ R19 및 C33 ~ C35)가 있다. 스너버는 GaN FET와 바이패스 네트워크의 상호 작용으로 인한 링잉을 감소시킨다. 스너버는 하이 사이드 FET의 드레인에 최대한 가깝게 연결해야 한다. 이들은 리드 유도 용량을 최소화하기 위해 표면 실장 저항기 및 낮은 유효 직렬 저항(ESR) 세라믹 커패시터로 구현된다.
R4, D1, C12 및 C13으로 구성된 부품 네트워크는 하이 사이드 게이트 드라이버용 부트스트랩 전원 공급 장치이다. D1은 빠르고 낮은 정전 용량의 다이오드여야 하는데, 이는 접합 정전 용량이 스위칭 손실에 기여하기 때문이다. R4는 돌입 충전 전류를 제한한다. 10Ω ~ 15Ω 범위의 값이 적합하다.
결론
EV부터 통신 및 산업 인프라에 이르기까지, 전력 변환 효율과 전력 밀도를 높이려면 기존의 Si 구조부터 바꿔야 한다. 지금까지 살펴본 바와 같이, GaN FET는 더 높은 작동 전압, 더 빠른 스위칭 시간 및 더 높은 효율성을 제공하여 차세대 설계를 위한 해결책을 제공한다. 설계자는 때에 따라 참조 설계로 지원되는 기성 부품을 사용하여 프로젝트를 신속하게 시작하고 진행할 수 있다.
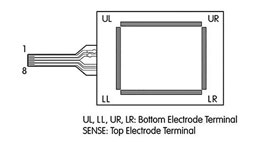
안정적인 터치스크린을 빠르게 구현하는 방법
조회수 216회 / Steven Keeping
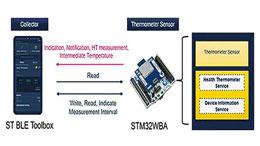
Bluetooth 5.3을 Edge IoT 설계에 빠르고 비용 효율적으로 추가하는 방법
조회수 425회 /

적절한 안전 컨트롤러 선택의 복잡성 해결
조회수 125회 / Jeff Shepard
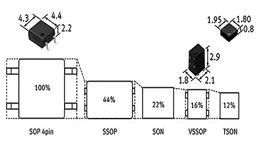
반도체 자동화 테스트 장비에 SSR을 사용하는 방법
조회수 137회 / Jens Wallmann
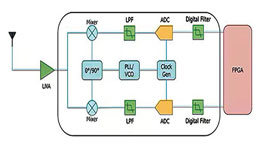
항공 우주 및 방위 산업의 적응형 SDR 통신 시스템에서 민첩한 RF 트랜...
조회수 396회 / Stephen Evanczuk
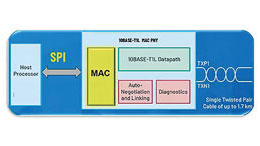
10BASE-T1L을 통한 건물 자동화 혁신
조회수 227회 / Rolf Horn

다기능 전원 공급 장치를 사용하여 지능형 화재 안전 및 보안 시스템 신...
조회수 366회 / Art Pini

전력 소자 구동기의 선택 및 시작하는 방법
조회수 592회 / Bill Schweber

DSC와 MCU를 사용하여 내장형 시스템 보안을 보장하는 방법
조회수 603회 / Stephen Evanczuk
PDF 다운로드
회원 정보 수정