[멘토 이벤트] 3D IC-패키지 그리고 HDAP 구현을 위한 설계 및 검증 방법
| 일 정 | 2020-03-17 ~ 2020-04-16 |
|---|---|
| 회 사 명 | Mentor, a Siemens Business |
| 발 표 | 4월 20일 |

| 3D IC-패키지 그리고 HDAP 구현을 위한 설계 및 검증 방법 |
발표자 : 김경록차장/멘토, 지멘스 비지니스
본 웨비나에서는 애플 아이폰7 이후로 적용되고 있는 TSMC사의 FOWLP, 그리고 CoWoS, SiP, High Pin-count Flip-Chip Package과 같은 인공지능 AI와 고성능 그래픽카드에 널리 적용되고 있는 HBM기반 Interposer Based Package의 설계 및 검증 솔루션 Xpedition IC Packaging 솔루션을 소개합니다.
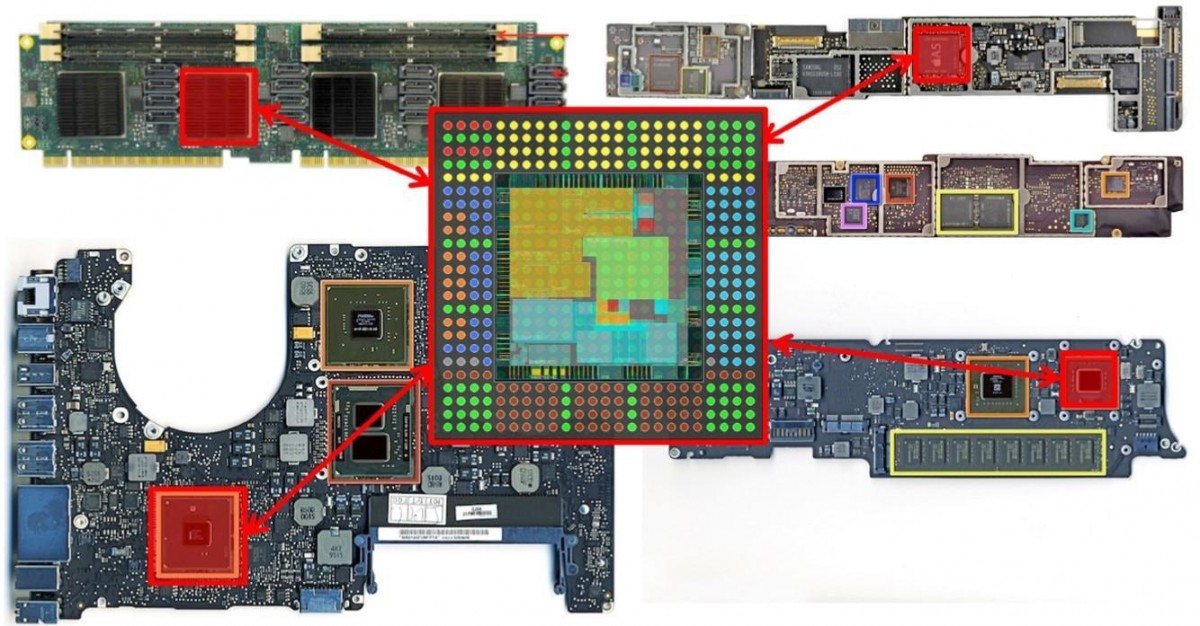
• 다양한 설계에 가장 적합한 패키징 솔루션
• 다양한 설계 방법론의 직접 통합
• 패키지별 검증 방법론
• 이종간의 3D IC-패키지 검증 방법
• Mentor Calibre와의 직접적인 통합
멘토 Xpedition IC 패키징 솔루션 :
인공지능 AI와 고성능 그래픽 카드에 널리 적용되고 있는 HBM 기반 Interposer Based Package 설계를 위한 가장 최적화된 설계 및 검증 통합 솔루션으로 새롭게 대두되고 있는 패키징 영역인 High Density Advanced Packaging (HDAP) 설계에 적합합니다.
이는 Xpedition Substrate Integrator(XSI)와 Xpedition Package Designer(XPD) 그리고 Calibre 3DSTACK의 통합 솔루션으로 HDAP외에도 빠른 프로토타이핑 어셈블리, 물리적 설계 및 검증, 사인오프 그리고 모델링을 제공합니다.

[당첨자 발표]

회원 정보 수정