TSV를 적용한 3DIC를 사용함으로써 센서 애플리케이션의 폼팩터 소형화
글/Helmut Hofstaetter, Andreas Wild, ams
센서와 센서 인터페이스 애플리케이션 같은 복잡한 전자 제품을 개발하는 시스템 엔지니어들에게는 폼팩터를 소형화하고, 향상된 기능성과 성능을 달성하고, BOM(bill of materials)을 줄이는 것이 당면 과제이다. 다이 크기를 줄이는 것은 더 높은 집적도가 가능한 더 축소된 프로세스 노드 기술을 사용함으로써 달성할 수 있으며, 시스템 소형화는 첨단 패키징 기술을 사용함으로써 달성할 수 있다. 갈수록 더 높은 수준의 시스템 통합을 요구함에 따라서 전통적인 어셈블리 서비스 업체들뿐만 아니라 반도체 업체들까지도 더더욱 혁신적이며 향상된 패키징 기술을 개발해야만 하게 되었다. 이와 관련해서 유망한 기술이면서 또한 까다로운 기술이 TSV(through silicon via: 실리콘 관통 비아)를 적용한 3차원 집적 IC(3DIC) 기술이다. 3DIC 기술은 현재 디지털 IC에는 널리 사용되고 있으며(예를 들어서 메모리 IC와 이미지 센서와 여타 소자 적층) 디지털 분야 용으로 설계와 제조 기법은 성공적으로 검증되고 있다. 그렇다면 아날로그 및 혼성신호 중심적 센서 IC로는 3DIC 기술을 어떻게 성공적으로 구현할 수 있을 것인가?
앞서 가는 아날로그 및 혼성신호 IC 개발자들이 아날로그 3DIC 구현의 여러 가지 이점들을 인식하기 시작했다. 스마트 센서와 센서 인터페이스 제품은 Industry 4.0, 스마트 시티, IoT 같은 다양한 애플리케이션에 사용된다. TSV와 BRDL(backside redistribution layer: 후면 재배치 층)는 다양한 방식의 칩 적층 시에 전통적 골드 와이어 본딩을 대체할 수 있는 아주 유용한 기술들이다. 3D 집적 기술을 사용하면, 특히 주요 파운드리 서비스 업체들이 제공하는 전문적 아날로그 TSV 기술과 전면 또는 후면 RDL 기술을 결합해서 사용하면, 더 소형화된 보드 풋프린트로 더 높은 기능성을 달성하고, 인터커넥트를 단축함으로써 성능을 향상시키고, 더 높은 수준의 집적도를 달성할 수 있다. 특히 TSV 패키지 기술을 사용하면 크기를 소형화할 수 있으므로(0.32mm 대의 총 높이 달성) 스마트 워치나 스마트 안경 같은 웨어러블 제품의 소형화된 폼팩터 요구를 충족할 수 있다.
또한 TSV 기술은 상이한 웨이퍼 또는 기술들을 결합할 때 더 높은 유연성을 가능하게 한다. 예를 들어서 45nm 프로세스로 제조된 디지털 웨이퍼와 아날로그 웨이퍼(180nm)의 웨이퍼 대 웨이퍼 적층이나 MEMS 디바이스 또는 포토 센서와 포토 다이오드 어레이를 적층하는 것 같은 다양한 방식의 적층이 가능하다.
아날로그 3DIC 기술은 통상적으로 센서 애플리케이션의 요구를 충족하기 위해서 칩 전면에서 IC 후면으로 전기적 접속을 형성한다. 광학, 화학, 가스, 압력 센서 같은 다양한 센서 애플리케이션에서 센싱 부위는 CMOS 상(웨이퍼 상단면)에 존재한다. 다이와 리드 프레임 사이에 가장 일반적으로 사용되는 접속은 와이어 본딩이다(그림 1). 그런데 플라스틱 패키지를 사용하든 아니면 다이를 PCB나 플렉서블 기판으로 직접 접착하든 상관 없이 노출 센싱 부위를 사용한 애플리케이션에서는 와이어 본딩은 이상적인 솔루션이 아니다. 바로 이럴 때 전문적인 파운드리 업체의 전문적인 TSV 기술을 사용함으로써 TSV, 후면 RDL, 칩 스케일 패키징(WLCSP)을 사용해서 본드 와이어를 대체할 수 있다(그림 2).
차세대 TSV
반도체 기술이 매번 더 축소된 프로세스 기술을 사용해서 더 높은 성능과 더 높은 집적도를 달성할 수 있게 된 것(‘무어의 법칙’)과 마찬가지로, 차세대 TSV 기술은 현재 가능한 3DIC 기술보다 더 우수한 성능을 달성할 것이다. 현재 몇몇 전문적인 파운드리 업체들이 자사의 차세대 TSV 기술을 개발하고 있다. 그러면 직경이 훨씬 더 작아짐으로써(약 40μm) 더 작은 피치가 가능해질 것이며, 그러면 동일한 또는 훨씬 더 우수한 아날로그 성능으로 더 높은 밀도를 달성할 수 있을 것이다. 이러한 차세대 TSV 기술을 토대로 새로운 3D 애플리케이션들이 가능할 것이다. 바로 이러한 예로서 파운드리 회사들은 ‘써드파티 웨이퍼의 패드 대체’나 ‘능동 3D 인터포저’ 같은 새로운 서비스를 제공하고자 준비하고 있다...(중략)

ams, 미래의 센서와 센서가 여는 미래
조회수 1476회 / Pierre Laboisse

LED 조명 백색 튜닝에 폐쇄 루프 제어를 사용해야 하는 이유
조회수 1733회 / Tom Griffiths

47.5메가픽셀의 고해상 고속 글로벌 셔터 CMOS 이미지 센서
조회수 2616회 / Pieterjan Daelemans

절대 위치 감지: 정교한 브러시리스 DC 모터 제어의 핵심
조회수 3610회 / Norwood Brown

헤드셋에서 USB-C와 경쟁하는 3.5mm 이어폰 잭
조회수 2815회 / Horst Gether
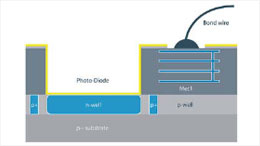
XYZ 컬러 센싱에 관한 11가지 오해
조회수 2950회 / Tom Griffiths
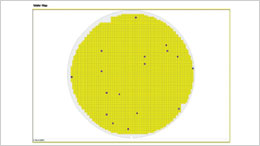
불량 디바이스 검출 효율을 높이는 혁신적인 저전압 테스트 기법
조회수 3621회 / Peter Sarson 외 1인
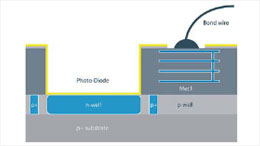
TSV를 적용한 3DIC를 사용함으로써 센서 애플리케이션의 폼팩터 소형화
조회수 2973회 / Helmut Hofstaetter 외 1인

사물 인터넷(IoT)을 위한 센서 기술
조회수 2734회 / Tom Griffiths
PDF 다운로드
회원 정보 수정